- Главная
- Компьютерные сети и технологии
- Микропроцессорные системы
- Цифровые устройства
- Оптоволоконные системы
Технологический процесс изготовления эпитаксиально-планарного транзистора
Эпитаксиально-планарная структура со скрытым слоем. Здесь эпитаксиальный коллектор легируют умеренно (необходимую концентрацию примеси рассчитывают из условия пробоя перехода база - коллектор), а малое сопротивление коллектора обеспечивают параллельно включенным скрытым слоем (n+), имеющим высокую концентрацию примеси.
Начальные стадии технологического процесса получения эпитаксиально-планарной структуры со скрытым слоем приведены на рис. 2.2. В поверхностном окисном слое пластины p-типа вскрываются окна, через которые проводят диффузию примеси с высокой концентрацией. Для того чтобы избежать значительного проникновения примеси в эпитаксиальный коллектор при последующих циклах высокотемпературной обработки (разделительная диффузия, базовая диффузия и т.д.), подбирают примесь с малым коэффициентом диффузии (например, мышьяк). Далее поверхность освобождают от окисла и наращивают эпитаксиальный слой кремния n-типа. После окисления поверхности процесс обработки протекает по той же схеме, что и для структуры без скрытого слоя.
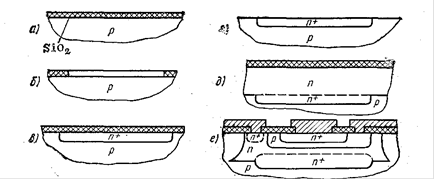
Рис. 2.2. Последовательность формирования эпитаксиально-планарной структуры со скрытым n+-слоем:
а-исходная пластина; б-вскрытие окон под диффузию скрытого слоя; в-диффузия n+-примеси, окисление поверхности; г-стравливание окисла, подготовка поверхности, д - эпитаксиальное наращивание n-слоя, окисление поверхности; е - готовая структура после разделительной диффузии, формирования базовых и эмиттерных областей, а также межсоединений.
Транзистор на основе МДП-структуры
|
| |
|
| |
|
| |
|
| |
|
|
Эпитаксия
Эпитаксия - это процесс осаждения атомарного кремния на монокристалическую кремниевую пластину, при котором получают пленку, являющуюся продолжением структуры пластины. Практическое значение имеет случай, когда легированная эпитаксиальная пленка выращивается на легированной пластине, т.е. когда одновременно с атомами кремния в росте кристалла принимают участие и атомы легирующего элемента. При различных видах примеси в пластине и в выращиваемой пленке на границе их раздела образуется p-n переход. Таким образом, в эпитаксиально-планарных структурах тонкий эпитаксиальный слой (2-10 мкм) содержит элементы ИМС, а подложка толщиной -500 мкм играет конструкционную роль.
В зависимости от агрегатного состояния источника атомов полупроводника и примеси для растущей пленки различают эпитаксию из газовой, жидкой и твердой фаз. Промышленное применение нашли газофазная (ГФЭ) и жидкофазная (ЖФЭ) эпитаксии.
При ГФЭ атомы кремния и примеси выделяются на пластине в результате химических реакций из соединений кремния и легирующего элемента. Для совершенства структуры важно прежде всего, чтобы в достройке участвовали одиночные атомы, а не их группы.
Основные условия, обеспечивающие совершенство структуры эпитаксиального слоя, следующие:
Читайте также
Проектирование устройства автоматической компенсации доплеровской частоты для СДЦ РЛС 5Н84А
Широкое
применение радиолокационной техники в военных целях (воздушная и наземная
разведки, навигация, вывод на траекторию ракет различного назначения) вызвало в
последние годы бурное р ...
Модуль шестнадцатиразрядного двоичного реверсивного счетчика с параллельно-последовательным переносом, с предустановкой и выводом информации по два разряда, начиная с младшего
В настоящее время происходит компьютеризация практически во всех областях
науки, техники, производства…Предпочтение отдается цифровым технологиям,
которые считаются более продвинутыми и ...
Перспективы развития транкинговой радиосвязи
Системы
транкинговой радиосвязи, представляющие собой радиальнозоновые системы
подвижной УКВ радиосвязи, осуществляющие автоматической распределение каналов
связи ретрансляторов между а ...

 С помощью плазмохимического осаждения и фотолитографии положим диэлектрич. Маску.
С помощью плазмохимического осаждения и фотолитографии положим диэлектрич. Маску.  С помощью ВТД внедряем атомы ионирующего элемента и удаляем диэлектрик.
С помощью ВТД внедряем атомы ионирующего элемента и удаляем диэлектрик.  Используя высокую температуру окисления положим диэлектрическую маску.
Используя высокую температуру окисления положим диэлектрическую маску.  С помощью магнетронного распыления и фотолитографии наносим тонкое металлическое покрытие.
С помощью магнетронного распыления и фотолитографии наносим тонкое металлическое покрытие.