- Главная
- Компьютерные сети и технологии
- Микропроцессорные системы
- Цифровые устройства
- Оптоволоконные системы
Технологический процесс изготовления эпитаксиально-планарного транзистора
Среди планарных структур, в которых использованы биполярные транзисторы, исторически более ранней является диффузионно-планарная структура. Функции изоляции в ней выполняют р-n-переходы, ограничивающие области отдельных элементов и смещенные в обратном направлении. Для получения обратного смещения в области подложки, разделяющей элементы формируется омический контакт, связанный с наиболее низким потенциалом источника питания, а к изолирующим областям резисторов с помощью контактов подводится высокий потенциал.
В качестве исходной заготовки используют пластину монокристаллического кремния, равномерно легированного акцепторной примесью (дырочная электропроводность). После того как на заготовку нанесен слой окиси кремния Si02, методом фотолитографии в этом слое избирательно вытравливают участки прямоугольной формы и через образовавшиеся окна путем термической диффузии вводят атомы примеси-донора. Процесс диффузии совмещают с термическим окислением кремния, в результате которого на поверхности вновь образуется сплошной слой окисла. Таким образом, одновременно создаются коллекторные области всех транзисторов, а также изолирующие области всех диодов и резисторов для всех кристаллов групповой пластины. Вторичным вскрытием окон меньших размеров в окисле и последующей диффузией примеси-акцептора формируют р-области, выполняющие роль базовых областей транзисторов, анодов диодов и резисторов. В результате очередного (третьего) цикла фотолитографии, диффузии и окисления получают области эмиттеров, катоды диодов, а также высоколегированные области для последующего создания омических контактов к высокоомным коллекторным и изолирующим областям.
Для создания межэлементных связей в слое окисла вновь вскрывают окна и плоскость пластины покрывают сплошной металлической пленкой (обычно алюминиевой). При этом в местах, свободных от окисла, образуется контакт с соответствующими областями кремния. Заключительный цикл фотолитографии (по пленке алюминия) позволяет создать систему межсоединений, а также контакты по периферии кристаллов. Эти контакты будут использованы для коммутации кристаллов с внешними выводами корпуса.
Планарный транзистор (независимо от типа структуры) имеет коллекторный контакт в одной плоскости с базовым и эмиттерным контактами. Вследствие этого коллекторный ток преодолевает протяженный горизонтальный участок дна коллекторной области (под дном базы), имеющий малые поперечные размеры.
В диффузионном коллекторе концентрация активной примеси распределена по глубине неравномерно: она максимальна на поверхности и равна нулю на дне коллектора, - поэтому слой коллектора под базой имеет высокое сопротивление, что увеличивает напряжение насыщения и время переключения транзистора.
Равномерное распределение примеси по толщине коллектора может быть получено с помощью процесса эпитаксиального наращивания кремния с дозированным количеством донорной примеси. Такой процесс применяют для создания эпитаксиально-планарной структуры.
Чтобы получить простейшую эпитаксиально-планарную структуру, в качестве исходной заготовки надо использовать монокристаллическую пластину кремния, равномерно легированную акцепторной примесью. Для нанесения эпитаксиального слоя на одну из сторон пластины ее освобождают от окисла и тщательно очищают (рис. 2.1), после чего проводят осаждение монокристаллического слоя кремния n-типа. Далее поверхность пластины окисляют и методом фотолитографии вскрывают окна в виде узких замкнутых дорожек, соответствующих контуру коллекторных и изолирующих областей ИМС. Проводя через окна диффузию акцепторной примеси до смыкания ее с р-областью, получают таким образом изолированные друг от друга островки равномерно легированного эпитаксиального n-кремния.

Рис. 2.1. Последовательность формирования эпитаксиально-планарной структуры:
а - исходная пластина; б - стравливание окисла, подготовка поверхности; в-эпитаксиальное наращивание n-слоя, окисление поверхности; г - вскрытие окон в окисле под изолирующую (разделительную) диффузию примеси; д - диффузия акцепторной примеси, окисление поверхности; е - готовая структура после формирования диффузионных базовых и эмиттерных областей, а также получения межсоединений.
|
Схема структуры |
Оборудование, метод |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
| |
|
|
Читайте также
Организация сети широкополосного доступа Комсомольского микрорайона г. Краснодара
Сегодня
потребность пользователей Интернет в передаче большого объема данных на высокой
скорости стремительно растет. Это связано с увеличением качества используемых
данных, и как резул ...
Проектирование спутниковой линии связи между городом Якутск и поселком Черский
Стремительное развитие космонавтики, успехи в изучении и
исследовании околоземного и межпланетного космического пространства выявили
весьма высокую эффективность использования околоз ...
Проектирование радиорелейной линии связи
Радиорелейная связь - один из видов радиосвязи, образованной
цепочкой приёмо-передающих (ретрансляционных) радиостанций. Наземная
радиорелейная связь осуществляетс ...
 Пластина монокристаллического кремния с нанесенной окисью кремния.
Пластина монокристаллического кремния с нанесенной окисью кремния.  Нанесение диэл. маски, используя высокую температуру окисления и фотолитографию.
Нанесение диэл. маски, используя высокую температуру окисления и фотолитографию. 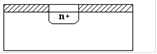 Внедрение n+ путём эпитаксиальной планарной технологии и очистка от диэлектрика.
Внедрение n+ путём эпитаксиальной планарной технологии и очистка от диэлектрика. 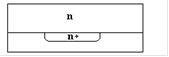 С помощью газовой эпитаксии делаем наращивание слоя n.
С помощью газовой эпитаксии делаем наращивание слоя n. 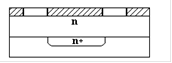 Используя процесс фотолитографии и плазмохимического наращивания, наносим диэлектрическую маску.
Используя процесс фотолитографии и плазмохимического наращивания, наносим диэлектрическую маску. 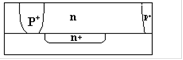 С помощью ионной ВТД эмитации внедряем в п-тии атомы??? элемента и очищающего от диэлектрика.
С помощью ионной ВТД эмитации внедряем в п-тии атомы??? элемента и очищающего от диэлектрика. 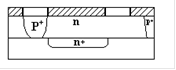 Снова наносим диэлектрическую маску.
Снова наносим диэлектрическую маску. 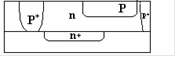 Снова с помощью ВТД внедряем атомы ионирующего элемента и удаляем диэлектрик.
Снова с помощью ВТД внедряем атомы ионирующего элемента и удаляем диэлектрик. 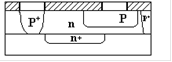 Нанесение диэлектрика.
Нанесение диэлектрика. 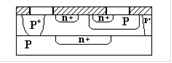 Наносим диэлектрик.
Наносим диэлектрик. 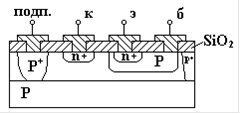 Нанесение металлической плёнки с помощью магнетронного распыления и снятие плёнки.
Нанесение металлической плёнки с помощью магнетронного распыления и снятие плёнки.